【半導体:17】0.25µm DRAM Pause Refresh異常の物理的正体
topics: [“半導体”, “DRAM”, “故障解析”, “デバイス物理”, “プロセス”]
🧭 はじめに
前稿では、0.25µm世代DRAMにおいて
Pause Refresh 条件で観測された異常の「現象」のみを記録した。
本稿では、その現象が
どの物理挙動に対応していたのかを整理する。
結論から言えば、
これは単なる「保持不良」という言葉で括れる現象ではない。
支配因子は、セル容量でも回路でもなく、
プロセス起因のリーク物理だった。
🔍 観測結果が示していた物理的ヒント
前編で列挙した観測事実は、
すべて同じ方向を指していた。
- ランダム単一ビット
- 強い温度依存
- 一部可逆性
- 配置・データ非依存
これらを同時に満たす物理条件は限られている。
- 局所的に発生する
- 熱活性化される
- 永久破壊ではない
この時点で、
支配因子はほぼ一つに絞られていた。
🎯 支配因子:ジャンクションリーク
Pause Refresh 異常の正体は、
セルMOSトランジスタのジャンクションリーク電流である。
特に支配的だったのは、
- n⁺ / p⁻ 接合近傍
- 拡散端部
- 絶縁境界(STI / LOCOS)周辺
に存在する 欠陥準位を介したリークだった。
🧬 リークが発生する断面構造(参照図)
ここで、Pause Refresh 異常を理解するための
物理的前提となる断面図を示す。
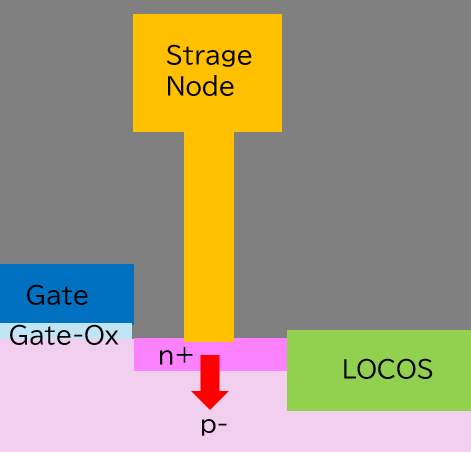
図1:0.25µm DRAMセルにおける ジャンクション端部リーク経路(概念断面図)
この図が示すのは、
リークが「セル全体」ではなく、
ごく局所的な構造端部に集中するという事実である。
- ゲート端
- 拡散端
- 絶縁端
これらはすべて、
プロセスダメージが蓄積しやすい場所でもある。
🔁 SRH再結合が作る振る舞い
このリークは、
Shockley–Read–Hall(SRH)再結合に支配されていた。
SRHリークの特徴は明確だ。
- 温度に対して 指数関数的に増加
- 欠陥密度に強く依存
- デバイス寸法より プロセス履歴に敏感
この特性により、
- 高温で突然 Fail が増える
- 温度を下げると Fail が消える
という 可逆的挙動が自然に説明できる。
🎲 なぜ「ランダム単一ビット」になるのか
SRHリークは、
- ウェーハ全面に均一
- セルごとに同一
ではない。
欠陥は、
- 局所的
- 統計的
- 再現性はあるが配置規則を持たない
という性質を持つ。
その結果、
- 連続ビットにならない
- 行・列依存を持たない
- 空間的な“地図”が描けない
ランダム単一ビット Failとして観測された。
🚫 セル容量は関係していなかった
ここが重要な転換点である。
Pause Refresh 異常は、
- キャパシタ容量不足
- 設計マージン不足
では説明できなかった。
容量を増やしても、
- 高温条件では Fail は消えない
- Fail 発生セルは固定
だったからだ。
保持時間は、
容量ではなくリークで決まっていた。
🧪 プロセス履歴との強い相関
Fail発生率は、
特定のプロセス条件と強く相関していた。
代表例は次の通り。
- プラズマエッチング条件
- ドライアッシング工程
- 接合形成後の表面処理
これらはいずれも、
界面欠陥密度を増やす方向
に働く。
プロセス条件を変えると Fail が減り、
元に戻すと再発する。
この再現性は、
物理起因であることの決定的証拠だった。
⏸ なぜ Pause 条件でだけ顕在化したのか
通常動作や通常リフレッシュ中は、
- 書き込み
- 読み出し
- 定期的な再充電
によって、リークは“見えにくい”。
Pause Refresh 条件では、
- 電荷は一切補充されない
- 時間だけが経過する
このため、
リーク電流 × 無補充時間
が、そのままデータ消失として現れる。
Pause Refresh は、
リーク物理をそのまま露出させる条件だった。
🧾 まとめ(物理編)
0.25µm DRAM の Pause Refresh 異常は、
- 設計の問題ではない
- 容量の問題でもない
プロセス起因の欠陥が作るリーク物理だった。
- 支配因子:SRHリーク
- 感度因子:欠陥密度
- 増幅因子:温度
- 顕在化条件:Pause(無補充時間)
この現象は、
設計で議論すべき対象では最初からなかった。
🔗 一次情報(参照元)
-
Legacy Technology Archive
https://samizo-aitl.github.io/Edusemi-Plus/archive/legacy/ -
0.25µm DRAM ケース
https://samizo-aitl.github.io/Edusemi-Plus/archive/legacy/dram_025um/ -
Pause Refresh Fail 詳細
https://samizo-aitl.github.io/Edusemi-Plus/archive/legacy/dram_025um/pause/
⏭ 次回予告
次稿から、
PSRAM(2001年)ケースに入る。
まずは
「PSRAMは何を狙った技術だったのか」
――構造と前提だけを扱う。