【半導体:16】0.25µm DRAMで観測されたPause Refresh異常
topics: [“半導体”, “DRAM”, “故障解析”, “信頼性”, “プロセス”]
🧭 はじめに ― 理屈が追いつかない異常
0.25µm世代のDRAMでは、
従来の経験則では説明できない異常が観測された。
それが Pause Refresh Fail である。
本稿では、
- どのような条件で
- どのような挙動として
- どのように観測されたのか
を 解釈を加えずに 記録する。
原因や物理的説明は 次稿 に回す。
ここでは、あくまで「現象そのもの」に限定する。
🧪 Pause Refresh テストとは何か
Pause Refresh テストは、
DRAMセルの 保持特性だけ を切り出して評価する試験である。
基本的な手順は以下の通り。
- 📝 セルに既知データを書き込む
- ⏸ リフレッシュ動作を停止する
- ⏳ 一定時間、完全に放置する
- 🔍 再度読み出し、ビットエラーを取得する
アクセスもリフレッシュも行わない状態で、
どのセルが、どれだけ電荷を保持できるか を観測する。
当時としては、
特殊な評価ではなく 標準的な信頼性評価項目の一つだった。
🔍 観測された異常
① Fail bit map が「描けない」
最初に強い違和感が出たのは、
Fail bit map の分布だった。

図1:Pause Refresh 条件下で取得した Fail bit map (0.25µm 世代 DRAM)
観測された特徴は以下の通り。
- 行方向の偏りがない
- 列方向の偏りがない
- ブロック単位の集中もない
Failは、
ランダムに点在する単発ビットとして現れた。
特定ワードライン、特定領域、
特定配線方向に 地図が描けない。
これは、
従来のレイアウト起因不良や配線起因不良とは
明確に様相が異なっていた。
② 単一ビット支配
Pause Refresh Fail の大半は、
- 連続ビットではない
- クラスタ化しない
単一ビットエラーとして観測された。
複数ビット同時崩壊や、
面積に比例した壊れ方は見られない。
セル単位で、
孤立して壊れているように見える挙動だった。
③ 温度依存が極端
温度条件を変えると、
Fail数は 非線形に変化した。
- 🌡 室温付近:Failはほぼ観測されない
- 🔥 高温条件:Failが急激に増加する
一方で、温度を下げると
Failが消失するセルも存在した。
この 可逆性 は、
永久欠陥や機械的破壊とは異なる特徴だった。
④ データパターン依存がない
書き込みデータを変えても、
- All-0
- All-1
- チェッカ
- ランダム
Failの分布や数に有意な差は現れない。
データ内容や隣接ビット状態による
再現性の変化は確認されなかった。
🧱 セル構造との対応を考えるための前提図
この時点では 原因は未確定 だったが、
議論の前提として
セル構造の空間関係は共有されていた。
メモリセル平面レイアウト(参照)
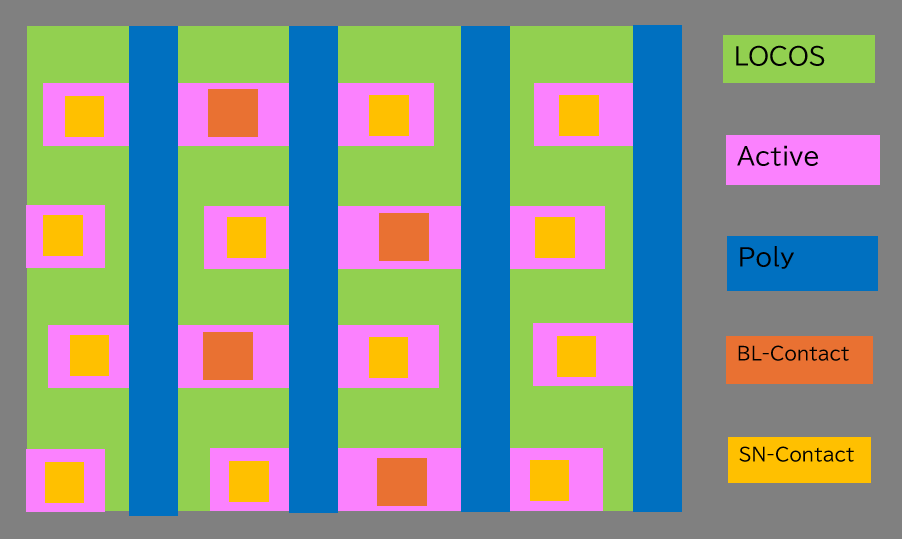
図2:DRAMメモリセル平面レイアウト(概念図)
メモリセル断面構造(参照)
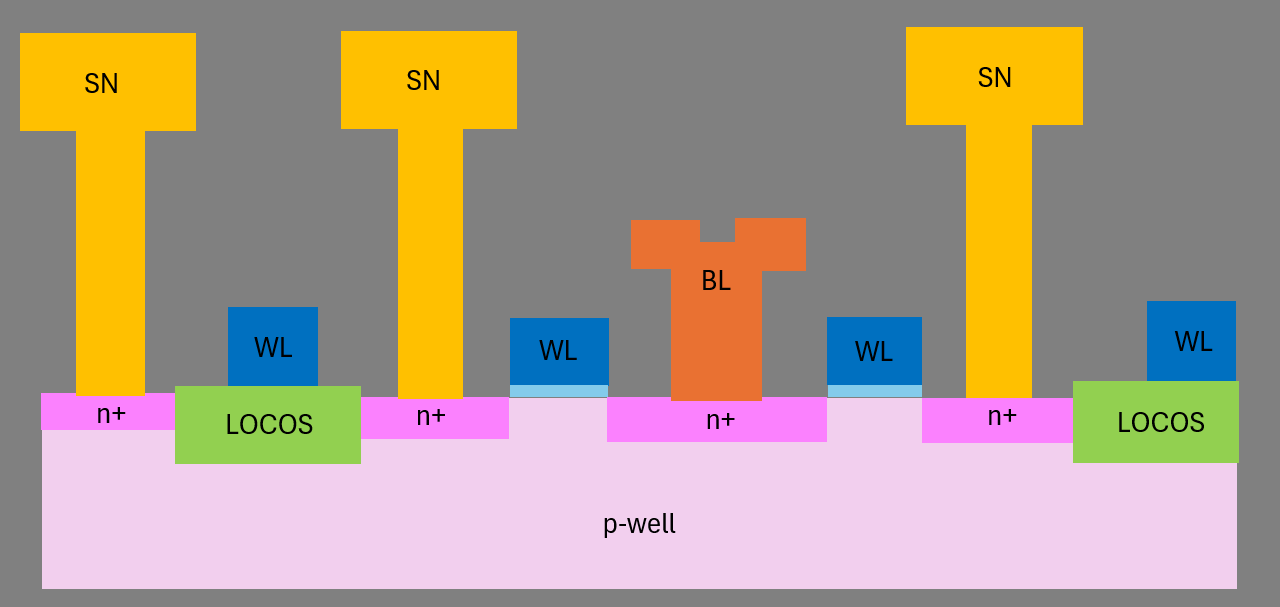
図3:DRAMメモリセル断面構造(概念図)
重要なのは、
これらの図から 直接原因を読み取れなかった という点である。
- 特定構造に紐づかない
- 特定方向性を示さない
- 配置依存性が見えない
Fail bit map のランダム性は、
セル構造と1対1に対応しなかった。
✅ この時点で確定していた事実
観測結果から、
次の点だけは比較的早い段階で共有されていた。
- セル容量不足を示す兆候ではない
- レイアウトや配線起因の不良ではない
- アクセス動作中に発生する故障ではない
Pause Refresh Fail は、
保持中に、ランダムなセルで電荷が失われる
という現象としてのみ、
確実に存在していた。
⚠️ 「おかしさ」が示していたもの
この異常は、
- 再現性はある
- 条件(特に温度)に強く依存する
- しかし空間的な規則性がない
という特徴を同時に持っていた。
この段階では、
- 故障名を与えること
- 原因を仮定すること
のどちらも まだ適切ではなかった。
分かっていたのは、
従来のDRAM不良像とは一致しない
という事実だけである。
🧾 まとめ(現象編)
0.25µm DRAMで観測された Pause Refresh 異常は、
次の特徴を持っていた。
- Pause Refresh 条件でのみ顕在化
- Failはランダムな単一ビット
- 強い温度依存と一部可逆性
- データ・配置依存性なし
違和感だけが、先に存在していた。
この違和感が、
後にまったく別の物理領域へ
議論を押し出すことになる。
🔗 一次情報(参照元)
-
Legacy Technology Archive
https://samizo-aitl.github.io/Edusemi-Plus/archive/legacy/ -
0.25µm DRAM ケース
https://samizo-aitl.github.io/Edusemi-Plus/archive/legacy/dram_025um/ -
Pause Refresh Fail 詳細
https://samizo-aitl.github.io/Edusemi-Plus/archive/legacy/dram_025um/pause/
⏭ 次回予告
次稿では、
この現象が どの物理挙動に対応していたのか を扱う。
解釈はするが、
設計の話には踏み込まない。